資料來源:聚財網
[20221008] 在先進封裝中,兩大龍頭台積電、日月光私下暗潮洶湧商場沒有永遠的朋友也沒有永遠的敵人,台積電與日月光真的能共創價值嗎?[1]兩大龍頭公司的封裝技術有彼此較勁的意味,台積電是以3DFabric,而日月光是以VIPack[2]。彼此技術概念是相近的,但是客戶會選擇誰呢?這恐怕是日月光要審慎思考,台積電的客戶有代工的需求而不會想要就近尋求解決嗎?會想要繞一大圈找另外的公司?對日月光而言,可能需要思索的有什麼附加價值、第二曲線可發展嗎? 孫子兵法的精神是專注、借力使力等,或許可以有靈光一閃的新想法。
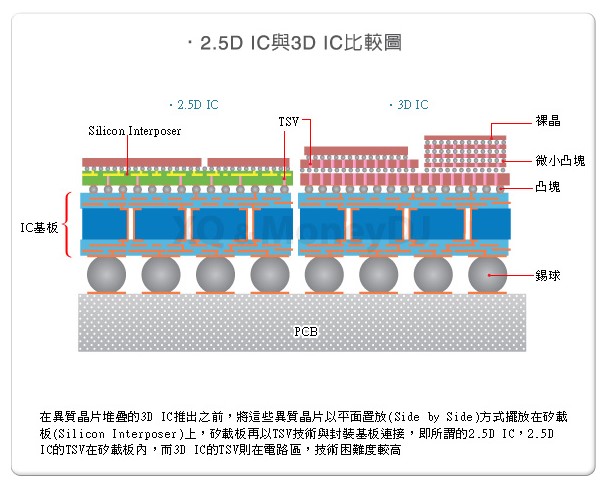
[2][20211201]日月光整合6大技術 首推VIPack™先進封裝平台
https://ec.ltn.com.tw/article/breakingnews/3947214
日月光投控(3711)旗下日月光半導體今日宣佈推出VIPack™先進封裝平台,提供垂直互連整合封裝解決方案,這平台是日月光擴展設計規則並實現下一世代3D異質整合架構。
台積電也跨足先進封裝,去年宣布將先進封裝相關技術整合為「3DFabric」平台,包括SoIC、InFO及CoWoS系列,讓客戶自由選擇搭配。日月光半導體也推出VIPack™先進封裝平台,顯示先進封裝市場具成長性,也具競爭性。
日月光表示,VIPack™是公司擴展設計規則並實現超高密度、性能設計的下一世代3D異質整合架構,此平台利用先進的重佈線層(RDL)製程、嵌入式整合及2.5D/3D封裝技術,協助客戶在單個封裝中集成多個晶片來實現創新未來應用。
日月光指出,走入以數據為中心的時代,隨著人工智能(AI)、機器學習(ML)、5G通信、高效能運算(HPC)、物聯網(IoT)和汽車應用數據的增長,半導體市場正呈指數級增長。對創新封裝和IC協同設計、尖端晶圓級製造製程、精密封裝技術以及全面的產品與測試解決方案的需求同步增長。
日月光進一步表示,為了各種應用的解決方案都要滿足嚴格的成本條件下,實現更高性能、更強功能及更佳功耗,因此封裝愈顯重要。隨著小芯片(chiplet)設計日趨主流,進一步提升將多個晶片整合到單個封裝內的需求。VIPack™是以3D異質整合為關鍵技術的先進互連技術解決方案,建立完整的協同合作平台。
日月光VIPack™由6大核心封裝技術组成,平台提供應用於先進的高效能運算(HPC)、人工智能(AI)、機器學習(ML)和網絡等應用的整合分散式SoC(系統單晶片)和HBM(高帶寬記憶體)互連所需的高密度水平和垂直互連解決方案。
[1][20211201]台積電、日月光對談 異質整合封裝 雙強各有一套
國際半導體產業協會(SEMI)30日舉辦領袖對談,晶圓代工龍頭台積電及封測龍頭日月光投控均認為,異質整合為半導體提供新價值,台積電和日月光雙方沒相互干擾或競爭,而是共創價值。台積電推出3DFabric先進封裝平台已建立且率先進入新階段,從系統整合到現在的系統微縮;日月光則由系統級封裝(SiP)出發,創造生產鏈系統整合創新價值。
台積電卓越院士兼研發副總經理余振華、日月光集團研發中心副總經理洪志斌同台,探討半導體產業異質整合面臨的挑戰與未來發展趨勢。
余振華表示,異質整合讓供應鏈有更多發揮空間,台積電及日月光都不再扮演傳統角色,而是借重供應鏈合作夥伴長處,由前段及後段分別往中間的異質封裝移動。異質整合封裝的領域很廣,高效能運算(HPC)是現在主流項目,台積電及日月光各有自己切入市場角度,雙方沒相互干擾或競爭,而是各自提供擁有自身長處的異質整合技術,創造價值並讓產業更完整。
余振華表示,台積電3DFabric平台已率先進入新階段,從異質整合到系統整合再到現在的系統微縮(system scaling),類似系統單晶片(SoC)講究效能耗能與尺寸微縮的進程,系統微縮新階段則是追求更高系統效能、更低耗能、以及更緊密尺寸與體積上的精進。
洪志斌表示,國際半導體技術發展路線圖(ITRS)2016年提出新方向,重新定義至異質整合路線圖(HIR),在此大趨勢提供往下發展的新技術主流,當中很重要的是涵蓋每個供應鏈、甚至半導體產業鏈的每個環節。日月光由傳統的封裝技術,延展到2.5D或3D封裝與後段測試,這種一條龍服務是日月光引以自豪的優勢。
Reference:
[3][2022XXXX]淺談半導體先進製程 3D封裝製程是什麼
矽通孔技術(TSV)實現Die與Die間的垂直互連,通過在Si上打通孔進行晶片間的互連,無需引線鍵合,有效縮短互連線長度,減少信號傳輸延遲和損失,提高信號速度和帶寬,降低功耗和封裝體積,是實現多功能、高性能、高可靠性且更輕、更薄、更小的晶片系統級封裝。
矽通孔技術(TSV)實現Die與Die間的垂直互連,通過在Si上打通孔進行晶片間的互連,無需引線鍵合,有效縮短互連線長度,減少信號傳輸延遲和損失,提高信號速度和帶寬,降低功耗和封裝體積,是實現多功能、高性能、高可靠性且更輕、更薄、更小的晶片系統級封裝。
2.5D IC的矽通孔技術(through-silicon via,TSV)在矽載板內,而3D IC的TSV則在電路區,技術困難度較高
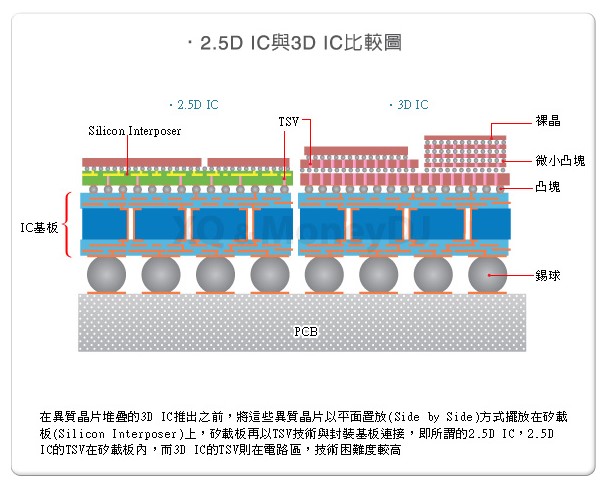
https://ec.ltn.com.tw/article/breakingnews/3947214
日月光投控(3711)旗下日月光半導體今日宣佈推出VIPack™先進封裝平台,提供垂直互連整合封裝解決方案,這平台是日月光擴展設計規則並實現下一世代3D異質整合架構。
台積電也跨足先進封裝,去年宣布將先進封裝相關技術整合為「3DFabric」平台,包括SoIC、InFO及CoWoS系列,讓客戶自由選擇搭配。日月光半導體也推出VIPack™先進封裝平台,顯示先進封裝市場具成長性,也具競爭性。
日月光表示,VIPack™是公司擴展設計規則並實現超高密度、性能設計的下一世代3D異質整合架構,此平台利用先進的重佈線層(RDL)製程、嵌入式整合及2.5D/3D封裝技術,協助客戶在單個封裝中集成多個晶片來實現創新未來應用。
日月光指出,走入以數據為中心的時代,隨著人工智能(AI)、機器學習(ML)、5G通信、高效能運算(HPC)、物聯網(IoT)和汽車應用數據的增長,半導體市場正呈指數級增長。對創新封裝和IC協同設計、尖端晶圓級製造製程、精密封裝技術以及全面的產品與測試解決方案的需求同步增長。
日月光進一步表示,為了各種應用的解決方案都要滿足嚴格的成本條件下,實現更高性能、更強功能及更佳功耗,因此封裝愈顯重要。隨著小芯片(chiplet)設計日趨主流,進一步提升將多個晶片整合到單個封裝內的需求。VIPack™是以3D異質整合為關鍵技術的先進互連技術解決方案,建立完整的協同合作平台。
日月光VIPack™由6大核心封裝技術组成,平台提供應用於先進的高效能運算(HPC)、人工智能(AI)、機器學習(ML)和網絡等應用的整合分散式SoC(系統單晶片)和HBM(高帶寬記憶體)互連所需的高密度水平和垂直互連解決方案。
[1][20211201]台積電、日月光對談 異質整合封裝 雙強各有一套
https://www.chinatimes.com/newspapers/20211201000100-260202?chdtv
余振華表示,異質整合讓供應鏈有更多發揮空間,台積電及日月光都不再扮演傳統角色,而是借重供應鏈合作夥伴長處,由前段及後段分別往中間的異質封裝移動。異質整合封裝的領域很廣,高效能運算(HPC)是現在主流項目,台積電及日月光各有自己切入市場角度,雙方沒相互干擾或競爭,而是各自提供擁有自身長處的異質整合技術,創造價值並讓產業更完整。
余振華表示,台積電3DFabric平台已率先進入新階段,從異質整合到系統整合再到現在的系統微縮(system scaling),類似系統單晶片(SoC)講究效能耗能與尺寸微縮的進程,系統微縮新階段則是追求更高系統效能、更低耗能、以及更緊密尺寸與體積上的精進。
洪志斌表示,國際半導體技術發展路線圖(ITRS)2016年提出新方向,重新定義至異質整合路線圖(HIR),在此大趨勢提供往下發展的新技術主流,當中很重要的是涵蓋每個供應鏈、甚至半導體產業鏈的每個環節。日月光由傳統的封裝技術,延展到2.5D或3D封裝與後段測試,這種一條龍服務是日月光引以自豪的優勢。

沒有留言:
張貼留言